- HOME
- ご利用案内
- 県有ビームライン概要
- BL18:EUV光照射ビームライン
BL18:EUV光照射ビームライン
偏向電磁石からのシンクロトロン放射光で、極端紫外線リソグラフィーに用いられる、波長13.5nmのEUV光(極端紫外線)を利用して実験ができるビームラインです。

EUV 光露光装置
|
光子エネルギー範囲 |
92 eV (注1) |
|
|---|---|---|
|
照射位置のビームサイズ |
0.5 mm × 0.7 mm |
|
|
照射時間の制御範囲 |
0.01 ~ 1800 s |
|
| 照射位置の強度 | 80 mW/mm2(注2) | |
| 照射位置の真空度 | 1 × 10−6 Pa以下 | |
注1:45degミラーを外すことにより、80~200 eVのエネルギー帯を有する光が利用可能
注2:減衰フィルターを調整することにより、0.02~80 mW/mm2の範囲で調整可能
研究分野 (キーワード)
極端紫外線リソグラフィー、フォトレジスト、反射率、透過率
実験ステーション
実験ステーションの概略を図1に示します。光源は通常の偏向電磁石で、2枚の凹面トロイダル全反射ミラー(Mirror 1とMirror 2)によって、高エネルギーX線をカットして下流チャンバーまで導いた後、45度反射の多層膜ミラーと金属Zrのフィルターによって光を92 eV(波長13.5 nm)に単色化して試料チャンバーに導入しています。試料はロードロックチャンバーを介して試料チャンバーへの出し入れを行いますので、試料の入れ替えに必要な時間は通常1時間程度です。試料チャンバー内には反射率測定用に2個の光検出器が装備されており、一方の検出器は角度可変で入射光と試料で反射された反射光を交互に検出することで、反射率を計測することが出来ます。また試料下にも光検出器が装備されており、試料台上の試料の透過率を計測することが出来ます。さらに、試料チャンバーにはガス導出入口が装着されており、四重極型質量分析器(Q-Mass)を接続することで、EUV照射時に発生するアウトガスの分析も行うことが出来ます。
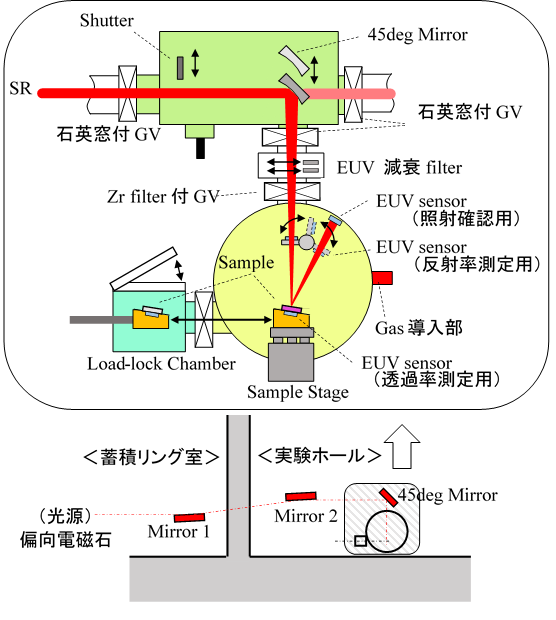
図1 BL18実験ステーションの概要
使用事例1:加工性評価の例
図2にレジストに見立てたPMMA(アクリル樹脂)をEUV光で露光したモデル実験の結果を示します。上図が各照射時間後に取得した外観写真、下図が各露光時間における溝の深さ形状プロファイル(膜厚計測計)です。40 sの露光では、まだ十分な深さに到達していませんが、400 s露光すると0.5 mm角程度の範囲で十分な露光が実現できていることがわかります。
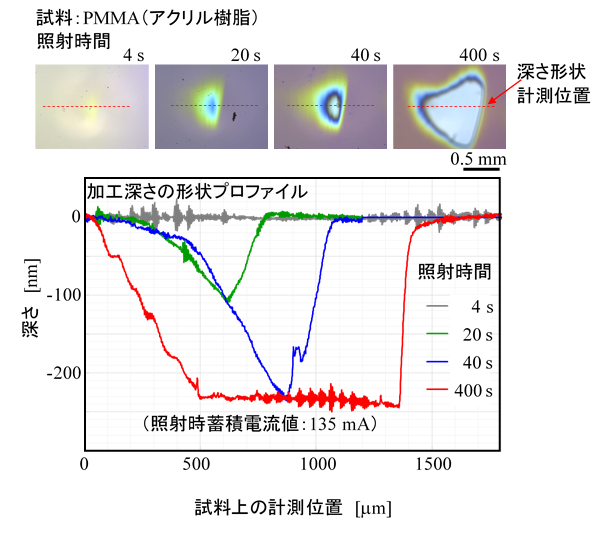
図2 PMMA露光結果
使用事例2:反射率の測定例
図3に反射率の測定例を示します。材料にはミラー材料ではなく通常のSiウエハを用いました。試料チャンバー内に設置してあるPIN検出器を用いて入射光と反射光の強度を交互に計測して反射率を計測します。この例では30秒ごとに両方の強度を計測しています。図3の表に示した計測を3回行い、その結果、Siウエハの反射率が十分な精度をもって0.017%であると結論づけることができました。
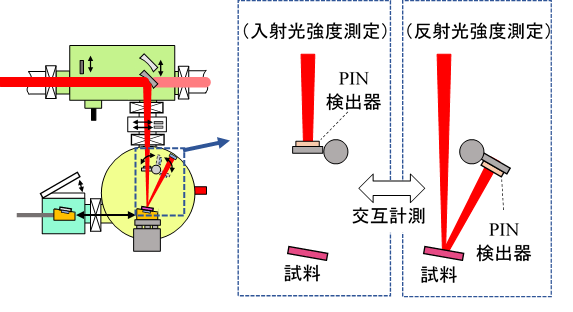
試料:Siウエハ

図3 シリコンの反射率の計測結果
使用事例3:薄膜の透過率計測例
図4に厚さ1.5 μm(カタログ値)のポリエチレン膜の透過率を計測した結果を示します。ポリエチレン膜はホルダーに写真のように挟み込みました。なお、試料導入時の急激な圧力変化に伴う膜の破損を防止するために、手動バルブにより任意の速度で真空引きが出来る機構も準備しています。透過率は、膜の有り無しで計測した透過光強度(PDの電流値)の比から計算で求めます。本計測では、膜の透過率は0.13%であることが判りました。
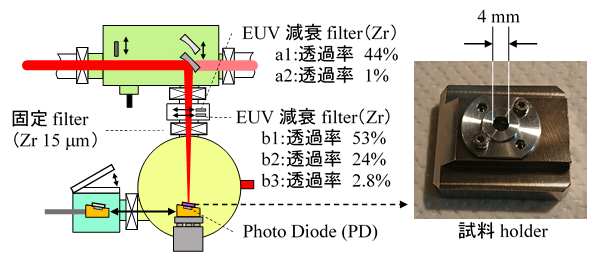
試料:ポリエチレン薄膜(~1.5 μm)

図4 ポリエチレン膜の透過率計測結果